作者:郭sy 时间:2025-04-25
许多利用激光的应用需要将激光整形为均匀度良好的细长平顶线,尤其是在显微镜、晶圆检测和激光剥离等领域。由于多模激光器每瓦成本低于单模激光器,因此通常使用多模激光器,这就需要基于扩散器和透镜阵列的整形方法。Holoor提出了一种改进部分相干激光源激光线束整形中窄轴方向积分强度均匀性的方法。所提出的方法涉及使用定制的各向异性扩散器(TAD,tailored anamorphic diffuser)来控制线两个维度上的相干性混合,从而提高均匀性。文中通过具体实例将该方法与现有解决方案进行了比较。此外,本文还探讨了所提方法的制造可行性,重点介绍了潜在的制造技术及其实用性。
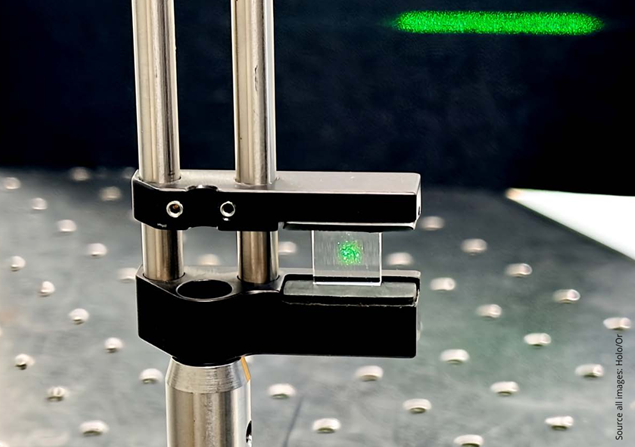
在各种激光应用中对均匀强度线形的需求
线状激光强度常用于扫描或类似应用中,在这种情况下,线的厚度被定义为单一单位-而不考虑沿窄轴方向的内部强度分布,因此可以描述为沿该维度的强度积分值。
与短线轴不同,沿长线轴的强度分布对性能有很大影响,无论是用于材料加工应用(如激光剥离和退火),还是用于显微镜应用(如半导体行业的激光晶圆检测或激光流式细胞术中的细胞分析)。在生物医学成像应用中,需要均匀的激光线光束来照亮生物组织中的感兴趣区域,并获取高对比度和高分辨率的高质量图像。共聚焦显微镜是依赖激光线光束整形的主要生物医学成像技术之一。在共焦显微镜中,使用窄激光线束来激发生物组织中的荧光物质,然后检测和处理产生的荧光信号,以生成组织的高分辨率图像。激光线束中的任何不均匀性都可能导致荧光素的不均匀激发,从而导致人为的假象和图像失真。在半导体行业中,用于晶圆检测的激光线束整形的均匀性至关重要。它能确保照明的一致性,增强缺陷的可见度,提高测量精度、实现有效的工艺控制,并简化设备校准和监测。通过保持均匀性,可以实现更精确的检测结果和更高效的生产流程。
通过采用这种一致性,半导体晶圆检测设备制造商能够显著提高其设备的产量。在用于薄膜从基板上分离的紫外激光剥离工艺中,均匀的激光线束整形也至关重要,这有助于实现薄膜与基板的稳定且可控的分离,并确保紫外激光剥离工艺的结果稳定且可重复。光東轮廓和能量分布的一致性可确保批次与批次之间性能的可重复性,从而将工艺变化和偏差降至最低。
诸如柱面透镜阵列之类的标准线形整形解决方案通常仅具有纯一维效果。这些方法稳健可靠,在要求不高的应用中通常效果良好但在线均匀性成为关键参数时则并非最佳选择。
由于沿长线轴的强度不均匀性是激光时间和空间相干性的函数,因此如果不增加线宽就很难对其进行改善。然而,对于部分相干(高M2)光束,正确利用其非相干性可以用来减少积分强度的变化。
部分相干激光束
部分相干激光是指其相位和强度存在一定程度的随机性或波动性的激光束,属于多模激光器的一种。部分相干的激光束在强度分布上可能会出现一些斑点,或者在波前上会表现出一定程度的畸变,部分相干多模激光器在每瓦功率的成本方面相对于单模激光器具有优势,并且被广泛应用于各种领域,包括材料加工、显微镜技术和光学相干断层扫描。
部分相干激光器主要有两种类型:
半导体激光器:激光二极管、激光二极管阵列和垂直腔面发射激光器阵列。它们的共同点在于均由多个发射器构成,其M2值由单个发射器的M2值乘以每轴发射器的数量来定义
光纤光源:光纤耦合激光器和光纤激光器对于这类激光器,最大M2值由光纤的芯径和数值孔径决定。
如何利用部分相干性来改善线形均匀度
要了解如何提高双面柱面透镜阵列的线形均匀度,我们首先必须明白是什么损害了这种均匀度-即由于激光相干性而产生的干涉斑点。
M2作为空间一致性的指标空间相干性通过M2值来经验性描述。部分相干激光器在每个轴上的M2值范围约为 5至50。标准的线整形器,如线扩散器,在长线轴上会增加M2值,而对短轴则无影响。由于自然发散M2和扩散器角度的共同作用添加线扩散器所导致的 M2 增加量可以从光束的总发散角推断出来:

其中,M2是光束的品质因子,θbeam是自然发散角,ω是束腰尺寸,λ是波长。
激光束可以表示为振幅和相位的复场。振幅决定了光束的尺寸,而相位决定了光束的发散度。
扩散器可以表示为纯相位元件,使得扩散器后整体的波束特性与扩散器前的波束特性相同,且发散角是原始波束发散角和扩散器发散角的组合。
对于上述方程,很明显,当激光束在窄线轴上的自然发散角θ的值显著高于该轴上的扩散器发散角(三倍或更多)时,窄线轴上的发散角总体变化很小。因此,在这种情况下,由于向窄轴添加扩散器而导致的线厚增加通常可以忽略不计(变化在10%或更小)。这意味着在窄轴上添加弱扩散对线宽影响不大,但正如我们将看到的,它对线的均匀性有显著影响。
通过添加非对称扩散来提高均匀性
通过添加各向异性扩散来提高均匀度在使用柱面微透镜阵列(MLA)进行线整形的情况下,入射光束会被双面柱面透镜阵列MLA的子透镜孔径分割成多个子光束。输入光束的性质决定了无论光束是单模还是多模,每个子光束非常类似于平面波,具有均匀的振幅和平坦的波前。通过加入一个聚焦透镜,所有子光束的干涉会形成一个单一的线状光束图像。一维微透镜阵列固有的有序结构会产生间距相等的斑点阵列,其典型尺寸由聚焦光学系统的衍射极限光斑大小决定。
由于聚焦光学系统的尺寸限制,提出了多种被动解决方案来提高线条形状的均匀性。所有这些方案的共同之处在于其工作原理-在每个子光束中引入随机性,从而使输出强度成为更随机的一维散斑,填充因子也更好。光束的时间相干性越低,均匀性就越好,因为形成散斑的干涉效率会降低。但即便消除了这些散斑沿线的幅度变化,利用这些概念所能达到的最高均匀性仍受一维散斑物理的限制,即对于相干性足够高的光束,干涉仍会在线中产生一定幅度的波动。
在此,Holoor介绍了一种利用定制的各向异性漫射器(TAD)将部分相干光束整形为线轮廓的新方法,以提高积分强度的均匀性。设计的关键要求是确保线厚度和长轴上的传输区域尽可能增加,并达到对预期应用可接受的水平。为了满足这一要求,扩散器的设计考虑了每个轴的定制扩散角,同时兼顾了激光束质量(M2)沿每个轴的光束尺寸以及微透镜阵列的数值孔径(NA)等因素为了实现更好的均匀性,最佳方法是使激光模式的平均偏移相对于线轴大约45°。这种偏移对于在两个轴上生成随机模式以及在短轴上积分时降低干涉强度是必要的。在实际应用中,Holoor将遵循由最大扩散角定义的上限条件:以确保在线宽可接受增加的同时保持所需的均匀度水平。定制扩散器的引入导致了线段短程强度的操控,如图1所示。在图1的左图中,红色圆圈代表由一维匀化器沿线段生成的部分相干光束的模式。强度分布沿短轴均匀但沿长轴不均匀。
通过使用根据激光束特性(如光束尺寸和M2值)专门设计的TAD,可以对强度分布进行细微调整。因此,长轴上的总强度表现出显著提高的均匀性,同时保持薄轴的厚度。这种效果在图1的右图中得到展示。
具体案例研究模拟作为展示均匀性改进的案例研究,我们定义了设计参数:
激光束参数:波长355纳米,光束尺寸(全宽半最大值)5mm,发散角:0.104,M2是20。
光学系统参数:扩束器9.1度全角度,由双面柱面透镜阵列MLA组成,间距0.25mm,EFL=1.575mm(ROC0.75mm),中心厚度2.3mm,EFL100mm。目标性能:线条尺寸(1/e2)15.9x0.2mm。
图2展示了本案例研究中所采用的光学装置示意图。该装置由三个紧密排列的光学元件组成:定制的各向异性扩散器、微透镜阵列均化器和聚焦透镜。输出强度在聚焦透镜的焦平面处进行测量。为了进行模拟,使用了菲涅尔积分相干传播的物理光学方法。这种方法考虑了聚焦透镜和焦平面远场之间的自由空间,使用单模高斯光束输入。为了展示多模的影响,对相干输出强度应用了卷积方法。这种成熟的技术允许展示与部分相干激光器相关的干涉效应。
在案例研究中,短轴发散通过衍射极限公式计算得出为0.104°。假设线厚度的上限约为衍射极限线厚度的10%,则可以通过入射光束发散和扩散角之间的角均方根和来计算增加的扩散角。结果的发散应该等于入射光束发散度的110%。
因此,扩散器的角度为:
对于长轴方向,增加的扩散器的角度可以相当大,但限制在于每个子光束的焦斑要小于第二级微透镜阵列的间距。长轴方向扩散器的角度越大对线边缘宽度的影响较小。为了展示增强的均匀性,我们模拟了光学系统的四种不同配置:1没有额外的扩散器-仅采用双面透镜阵列。2、一维扩散器。3、长轴方向扩散角与(2)相同的TAD。4、与(3)相同,但短轴扩散角为(3)的两倍。
图3显示了在模拟中使用的每个案例2-4中第一透镜阵列的凹陷。
强度分析
图4展示了案例研究系统在先前定义的四种配置下的性能。左测表示薄轴上的集成强度,而右列则展示了二维强度分布。正如预期的那样,正如预期的那样,仅具有双面柱面镜阵列的案例1系统表现出最强的强度。第二种配置在均匀性方面有了显著的提升,大约是前一种配置的三倍,不过强度波动仍呈现出明显的单向性。在第三种配置中,采用 TAD后,均匀性相比第二种配置又提高了三倍,同时仍保持线宽在规定的限度内。显然,强度分布在这两个轴上都实现了有效的均匀化,而没有出现前两种配置中仅在水平方向上的一维波动。最后一种配置展示了进一步提高均匀性的潜力,但代价是将线宽增加到约250微米。仅使用均质器与使用均质器加TAD相比改进效果显著。标准偏差从10.4% 降低至1%,和积分强度的均匀性从48.5%降至65%。
为了更深入地理解其效果,图5展示了在第三种配置中生成的完全相干光束在应用卷积平滑处理之前的强度分布。可以看出随着垂直轴上的随机化程度和斑点平均数量的增加,积分强度的均匀性得到改善。这种均匀性的增强与垂直轴上的扩散角成正比。
定制型线形扩散器实验结果
基于上述讨论的原则,Holoor设计并制造了一种双面透镜阵列,它将TAD表面与一个柱面MLA表面结合在一起。这是通过灰度光刻方法实现的,随后采用ICP刻蚀将光刻胶上的图案转移到玻璃上。所选的间距为227微米,有效焦距EFL设定为聚焦在厚度为2.29毫米的熔融石英基板的第二侧,从而产生6.5°的扩散角。计算得出,第一个透镜阵列表面的TAD扩散器组件在窄轴方向上产生0.11°的角度,在长轴方向上产生1.1°的角度。通过用M2=1.5、波长633纳米、光束直径4毫米的激光照射所得的线形扩散器,并将其直接聚焦到相机上,对其进行了表征。使用了两个透镜一-一个像差很大的双凸透镜,焦距为30毫米(用于在相机视场中观察整个线),以及一个焦距为150毫米的平凸透镜,用于精确测量线的均匀性和边缘锐度。在焦距为150毫米处进行测量时,线宽估计为0.116°,与设计线宽非常接近。
结论
本文讨论了在将激光束整形为线形轮廓时提高强度均匀性的挑战,针对部分相干激光源。通过采用定制的各向异性漫射器,实现了显著的改进。在集成强度均匀性方面取得了显著的改进。突破了现有方法的局限性对比分析表明了所提出的扩散器的优势。定制的各向异性匀化器通过考虑特定的激光束质量因子值,能够增强对强度分布的控制,从而实现均匀的激光线轮廓。这一理论上的改进在采用TAD的双面透镜阵列的实际实验结果中得到了验证,与标准的双面透镜阵列相比,其集成强度分布的均匀性显著提高(峰值与平均值之比约为15%) 。
这项研究的结果为开发高性能激光系统开辟了新的可能性,这些系统在广泛的应用中具有增强的精确度和效率,包括激光提升、激光检查和检测以及生物医学成像应用。
[1] R. Delmdahl, R. Paetzel, J. Brune, R. Senczuk, C. Gossler, R. Moser,
M. Kunzer, U. Schwarz: Line beam
laser lift-off approach for sapphire removal, ICALEO 2012 - 31st
International Congress on Applications of Lasers and Electro-Optics, 852-859,
DOI: https://doi. org/10.2351/1.5062551
[2] R. Delmdahl, R. Pätzel, J. Brune: Large-Area Laser Lift-Off
Processing in Microelectronics, Physics Procedia 41, 2013, pp. 241-248,
https://doi.org/10.1016/j.phpro.2013.03.075
[3] O. Haupt, J. Brune, M. Fatahilah, R. Delmdahl: Micro LEDs: high
precision large scale UV laser lift-off and mass transfer processes, Proc. SPIE
11989, Laser-based Micro- and Nanoprocessing XVI, 119890I (4 March 2022),
https://doi.org/10.1117/12.2610137
[4] Y. Mizuyama, N. Harrison & Riccardo Leto: Despeckling fly’s eye
homogenizer for single mode laser diodes, Opt. Express 21, 9081-9090 (2013),
https://doi.org/10.1364/oe.21.009081